《炬丰科技-半导体工艺》CMP后化学机械抛光清洗(2)
【作者】网站采编
【关键词】
【摘要】结论:在这项研究中,我们使用了一种新的方法来研究后化学机械抛光清洗过程中的颗粒去除机制。该方法从抛光实验开始,以便将颗粒粘附在晶片表面上
结论:在这项研究中,我们使用了一种新的方法来研究后化学机械抛光清洗过程中的颗粒去除机制。该方法从抛光实验开始,以便将颗粒粘附在晶片表面上。化学环境是专门为此而设计的。抛光后,进行清洗实验以研究颗粒去除机理。还特别考虑了表面活性剂的选择。结果表明,表面活性剂分子可以降低颗粒间的粘附力。对于较大的颗粒,用较高浓度的表面活性剂和较高的操作温度进行清洗被证明能有效地减小粘附在基底表面上的残余颗粒的尺寸。其机理主要是界面相互作用。
?
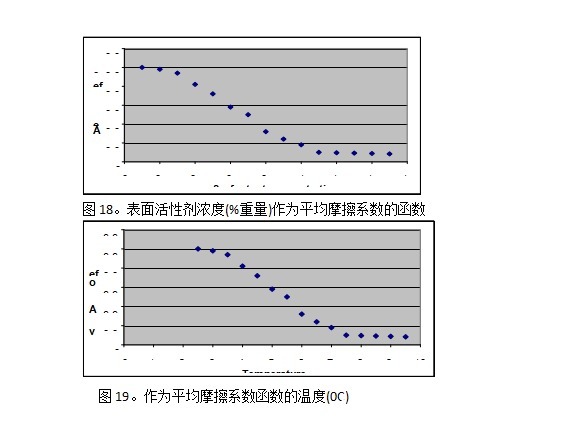
弹性表面上附着力的建模 ??略
?
结论
颗粒与晶片表面的粘附是化学机械抛光工艺中的主要问题之一。使用实验的化学机械抛光和化学机械抛光后清洗过程中的机理与数值分析相结合,粘附过程由颗粒和表面附近存在的范德华力控制。
结果表明,虽然表面活性剂分子可以减少颗粒之间的粘附,但机械去除仅对一定尺寸的大颗粒有效。对于较大的颗粒,用较高浓度的表面活性剂和较高的操作温度进行清洗被证明能有效地减小粘附在基底表面上的残余颗粒的尺寸。一旦颗粒尺寸达到临界尺寸,剩余的小颗粒将不能被有效去除。
对于剩余的小颗粒,加入表面活性剂可以有效去除颗粒。表面活性剂有两个基本作用。一是削弱粒子与粒子和表面之间的结合。另一个是防止颗粒和晶片表面之间的进一步粘附。其机理主要是界面相互作用。此外,利用弹性理论,我们能够分析表面中点处的垂直位移。范德瓦尔斯力被评估为分离距离的函数。我们发现,当距离达到临界值ALPHA时,范德华力将不再吸引。这一结果由误差%的稳定图和70到80范围内的ALPHA试验次数显示。
文章来源:《化学与粘合》 网址: http://www.hxyzhzz.cn/zonghexinwen/2021/1208/676.html
上一篇:化学世界-从最软到最硬物质
下一篇:新型坚韧、环保粘合剂:科学家改造其化学结构